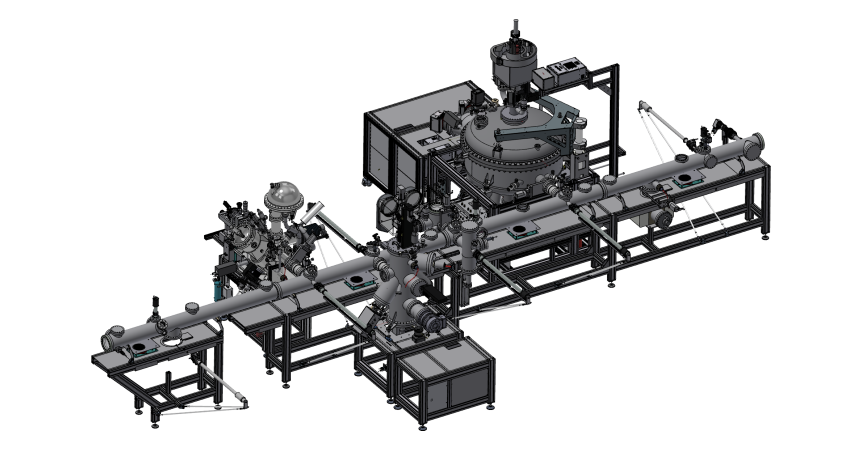
P374 – UHV sputter deposition cluster tool TU/e
Application
UHV sputter deposition cluster tool for thin film and multilayer deposition at 2″ substrates
Year of delivery
2014
Installation site
Technical University of Eindhoven, Netherland
Design Features
- UHV multichamber magnetron sputter deposition system with combination of confocal and face to face sputtering.
- The standard sample size and shape is 2″ wafer. Special shaped RHK STM samples possible too.
- UHV deposition chamber with nine 2″ magnetrons, three 3″ magnetrons and one multipocket e-beam source installed.
- Except of two 2″ magnetrons all sources can be used in face to face as well as confocal configuration.
- All magnetrons with manual in situ tilting and easy change able magent system.
- Linear multipocket e-beam with manual pocket exchange system and thickness controller incl. rate regulation & end point detection.
- Fully motorized 3 axes sample manipulator with integrated motorized wedge shutter, RF bias potential and maximal sample temperature above 850°C.
- Residual gas analyser system.
- UHV sample preparation chamber with gridded DC ion source, DC plasma oxidation setup and magnet stage installed.
- Fully motorized 2 axes sample manipulator with integrated DC bias potential and maximal sample temperature well above 900°C.
- Manual translating plasma oxidation stage.
- Magnet stage with motorized translation axis.
- UHV surface analytik chamber with XPS, UPS, ion source, electron source, flood gun and ErLEED installed.
- Fully manual 4 axes sample manipulator with integrated DC bias potential and maximal sample temperature above 900°C.
- Manual translating UV source.
- Manual translating X-Ray source with monochromator.
- Manual translating X-Ray source without monochromator.
- Storage chamber for 16 samples as part of the linear transfer system.
- Load lock chamber with storage for 6 samples, installed lamp heating option and connection port to a mini glove box.
- Semiautomatic sample transfer between all chambers via a linear distribution chamber system.
- One STM chamber system provided by RHK is connected to the linear transfer chamber system.
- Integrated bake out system with bake out tents at all chambers (except of load lock chamber).
Special Features
- Titanium sublimation pumps (TSP) with cryo shroud installed at all chambers (except of load lock).
- Handling incl. in situ exchange of sample masks in the sputter chamber.
- Different sample sizes and shapes from 2″ wafer down to 10mm x 10mm samples can be handled (using different kind of sample holders).
- Thin film deposition at STM tips possible in sputter chamber using special sample holder with included tip holder.
- Parts of the system are placed in a second lab room (linear transfer moves through a hole in the wall between both rooms).
Outer Dimensions
Technical specifications and performance values
General
Sputtering chamber
Size
1100 mm diameter, about 1160 mm height
Material
stainless steel
Sample preparation chamber
Size
300 mm diameter, about 930 mm height
Material
stainless steel
Analytik chamber
Size
240 mm diameter, about 880 mm length
Material
stainless steel
Load lock chamber
Size
160 mm diameter, about 300 mm height
Material
stainless steel
Linear transfer chamber
Size
4 segments with 165 mm diameter, about 2040 mm length each
Material
stainless steel
Vacuum
Sputtering chamber
Base pressure
< 2 * 10-10 mbar
Pump down time
2 hours to < 10-7 mbar
Chamber pumping
Turbo pumping stage in combination with titanium sublimation pumping stage, chamber lid as well as sample manipulator differentially pumped by dry foreline pump
Bake out
< 180°C
Sample preparation chamber
Base pressure
< 2 * 10-10 mbar
Pump down time
3 hours to < 10-7 mbar
Bake out
< 180°C
Chamber pumping
Turbo pumping stage in combination with titanium sublimation pumping stage and dry foreline pump
Analytik chamber
Base pressure
< 10-10 mbar
Pump down time
2 hours to < 10-7 mbar
Bake out
< 180°C
Chamber pumping
Turbo pumping stage in combination with titanium sublimation pumping stage and dry foreline pump
Load lock chamber
Base pressure
< 10-8 mbar
Pump down time
1/2 hour to < 10-6 mbar
Chamber pumping
Turbo pumping stage with dry foreline pump
Linear transfer chamber
Base pressure
< 2 * 10-10 mbar
Pump down time
< 3 hours to < 10-7 mbar
Chamber pumping
Ion getter pumping stage in combination with titanium sublimation pumping stage
Bake out
< 180°C
Manipulator features
Sputtering chamber
Sample size
diameter max. 2″ substrate
Motion axes
3 motorized axes (manipulator arm rotation, z tranlsation and (continous) sample stage rotation)
Motorized wedge shutter (part of the manipulator head) with a motion speed of min. about 0.4µm/s and max. about 5mm/s, incl. speed profile feature
Temperatures
Room temperature (not stabilized) up to 830°C at sample
Special features
RF bias potential option
Handling of sample masks
Handling of sample holder for STM tip coating
Sample preparation chamber
Sample size
diameter max. 2″ substrate
Motion axes
2 motorized axes (manipulator z translation and (continous) rotation of the sample stage)
Temperatures
Room temperature (not stabilized) up to 990°C at sample
Special features
DC bias potential option
Analytik chamber
Sample size
diameter max. 2″ substrate
Motion axes
4 manual axes (manipulator x, y & z translation and sample stage tilting)
Temperatures
Room temperature (not stabilized) up to 900°C at sample
Special features
DC bias potential option
Load lock chamber
Sample size
diameter max. 2″ substrate (max. 6 pieces)
Motion axes
2 manual axes (rotation, z translation)
Rotation axis equipped with an air side indexer plate for easy and fast sample loading via access door or transfer rod
Temperatures
Room temperature (not stabilized) up to 300°C at sample (not stabilized)
Sample preparation features
Sample preparation chamber
Oxydation /
Plasma treatment
max. 0.1 mbar partly ionised oxygen gas (using a TU/e designed oxidation plasma setup)
Gas mixture variable from pure argon up to almost pure oxygen
Ion beam etching /
sample precleaning
Wide range variation of ion source to sample distance
Wide range variation of ion energy and ion beam current