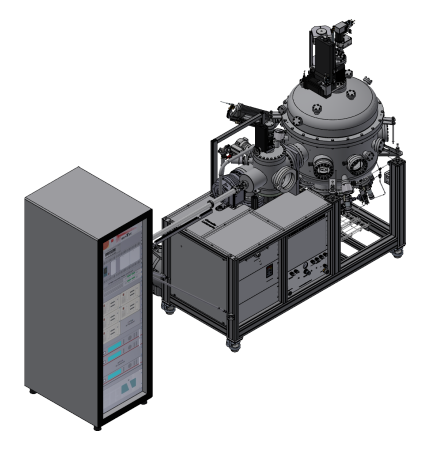
P450 – 4″ UHV sputter deposition UniA
Application
UHV sputter deposition system for thin film and multilayer deposition at 4″ substrates
Year of delivery
2016
Installation site
University Augsburg, Germany
Design Features
- UHV magnetron sputter deposition system with confocal sputter up configuration.
- Up to eight 2″ magnetrons in confocal configuration and up to four 3″ magnetrons in face to face configuration.
- 2″ magnetrons with manual in situ tilting.
- All magnetrons with easy changeable magnetic system for use with ferromagentic or non-ferromagnetic target materials.
- Fully motorized 2 axes sample manipulator with integrated motorized wedge shutter, DC bias potential option and maximal sample temperature above 800°C.
- Thickness sensor setup with manual translation stage for sputter rate check before deposition.
- Ion source for sample precleaning and mild etching.
- Residual gas analysis installed at the sputtering chamber.
- Load lock chamber with storage.
- Integrated bake out system.
Special Features
- System is prepared to be added to a cluster tool via second transfer port at sputtering chamber.
- System is prepared for ion beam assisted deposition as well.
- Reactive deposition possible.
- Different sample sizes from 4″ wafer down to 10mm x 10mm samples can be handled (using different kind of sample adapters).
Outer Dimensions
Technical specifications and performance values
General
Sputtering chamber
Size
700 mm diameter, about 850 mm height
Material
stainless steel
Load lock chamber
Size
200 mm diameter, about 300 mm height
Material
stainless steel
Vacuum
Sputtering chamber
Base pressure
< 2 *10-8 mbar
Pump down time
6 hours to < 10-7 mbar
Chamber pumping
Turbo pumping stage, chamber lid differentially pumped by dry foreline pump
Bake out
< 150°C
Load lock chamber
Base pressure
< 10-7 mbar
Pump down time
2.5 hours to < 10-7 mbar
Chamber pumping
Turbo pumping stage with dry foreline pump
Manipulator features
Sputtering chamber
Sample size
diameter max. 4″ substrate
Motion axes
2 motorized axes (z tranlsation and (continous) sample stage rotation)
Motorized wedge shutter (part of the manipulator head) with a motion speed of min. 49µm/s and max. about 4.9mm/s, incl. speed profile feature
Temperatures
Room temperature (not stabilized) up to 800°C at sample
Special features
DC sample bias is possible
Load lock chamber
(Sample storage)
Storage size
5 sample holders
Sample size
diameter max. 4″ substrate
Motion axes
2 manual axes (rotation, z tranlsation)
Rotation axis equipped with an air side idexer plate for easy and fast sample loading via access door or transfer rod
Sample preparation features
Sputtering chamber
Plasma treatment
Up to 10-3 mbar partly ionised argon gas (using a griddless ion gun)
Ion beam etching /
sample precleaning
Wide range variation of ion source to sample distance
Wide range variation of ion energy and ion beam current